
 | |
|
Слаботочка Книги 0 1 2 3 4 5 [6] 7 8 9 10 11 12 13 14 15 16 17 18 19 20 21 22 23 24 25 26 27 28 29 30 31 32 33 34 35 36 37 38 39 40 41 42 43 44 45 яосителсй заряда в полупроводнике имеет место очень сильная степенная зависимость вида тошв~1/(ио-"oпop) где для GaAs, GaP и соединений на их основе /ionop=55(3 ... 5)-10" см-, а 24 ... 6. В связи с этим говорят о концентрационном гашении люминесценции. Для компонентов прямого тока через р-п-переход, не инжектирующих электроны в р-область, справедливы соотношения /У==Л£е.чр {- В/Е), где Dp и Ly - коэффициент диффузии и диффузионная длина дырок в /г-области; ; -ширина области объемного заряда; £ -напряженность поля в области р-п-перехода при приложении к нему прямого смещения Uaj,; А а В - константы, определяемые конкретным видом распределения потенциала в переходном слое. В общем случае представить ток повер.хностных утечек /пов в аналитической форме не представляется возможным - он определяется эмпирически. Выражение для туннельного тока здесь приведено лишь в общей форме, не позволяющей сравнивать эту компоненту с /„; укажем лишь на резкую зависнмость /ту» от напряженности электрического поля в р-п-переходе: практически кривая /тун=/{£) носит пороговый характер. В том случае, когда туннельной и поверхностной компонентами тока можно пренебречь, выражение для у после несложных преобра-зованпй сводится к простой аналитической форме: V+ т L„ \ q (<p.-f/np) I 2ftr ; J где On. и Op - проводимости n- н р-областей. Первая добавка к 1 обусловлена неидеальиостью инжектирующих свойств р-п-перехода, вторая - рекомбинацией в области объемного заряда. При оценке коэффициента вывода излучения Котп потери на саиопоглощенне могут быть рассчитаны по формуле (!.9), для чего кроме геометрии кристалла необходимо точно знать длину волны излучения, так как зависимость Хо(Я) очень резкая (см. рис. L10). Вследствие эффекта полного внутреннего отражения наружу из кристалла выходят лишь лучи, падающие на границу раздела под углами, меньше критического: акр = arcsin (1/Иязл) (1.23) (угол Отсчитывается от нормали к поверхности). Если считать, что излучение в активной области кристалла изотропно и наружу выходят лишь лучи, лежащие в телесном угле аОкр, если учесть коэффициент отражения для этих лучей, то при условии пренебрежения потерями на поглощение для вывода излучения с одной стороны кристалла получим /Сопт~2-10 *. Практически наблюдаются н намного большие значения /Сопт, что обусловлено действием неучтенных факторов, таких, как многопроходные эффекты, переизлучепие, *) Напомним, что расчет по (1.23) справедлив для вывода излучения в воздух (п=1). отражение от плоскости омического контакта, фокусирующее действие мезаструктуры. Отмети.м, что теория светодиода не доведена до удобного аналитического представления и для определения выходных параметров излучателя приходится проводить численные расчеты, опирающиеся на эмпирические константы и справедливые лишь для конкретных структур. Многие из принятых допущений практически выполняются очень приближенно, поэтому полученные формулы пригодны лишь для оценок. Особенно существенные отклонения имеют место для , гетеросветодиодов, где мы сталкиваемся с принципиально новыми эффектами. Перейдем к рассмотрению процессов «в фотодиоде. Из определений (1.11), (1.12) и учитывая (1.1) и (1.2), получаем S [А/Вт] =0,8QX [мкм] =Qj3, [эВ]. (1.24) Второе равенство в (1.24) справедливо, если энергия генерируемых квантов hv-SgM3a. Из простого соотношения (1.24) следуют два полезных вывода. 1. Предельная для дайной длины волны излучателя фоточувстви тельность, достигаемая при Q-»t, составляет maxS=0,8X, а для данного полупровадникового материала может быть достигнута при К-»-Хгр и определяется как maxS [А/Вт]?фп [эВ]. 2. Если положить, что Ql или что Q не зависит от 7,, то вид спектральной характеристики S оказывается очень простым (рис. 1.13). Эксперименты подтверждают правильность этих предельных оценок и вид графика рис, 1.13. Отклонение реального вида зависимости S(X) в длинноволновой части спектра объясняется трудностью достижения Q=l, а в коротковолновой - возрастанием роли поглощения в р+-области и поверхностной рекомбинацией. Точный расчет Q в общем случае произвольной структуры провести не удается, поэтому обычно на.чодят значения Q для некоторых типичных конкретных структур. Выражения эти очень громоздки и ясному физическому анализу практически не поддаются [11, 15]. Представляется более полезным иметь пусть приближенное, но достаточно простое и общее аналитическое выражение. При расчете делаются следующие предположения; -- геометрия диода одномерна (изменение свойств происходит только в направлении х на рис. 1.П), - толщина р+-области столь мала, что потерями оптической энергии в ней можно пренебречь; - временем пролета и рекомбинационными потерими в обедненной области р-и-перехода можно пренебречь; - поверхностная рекомбипащия отсутствует; - поведение носителей подчиняется статистике Больцмана;  Рис. 1.13. Теоретиче< екая (---) и экспериментальная (- - -J спектральные завися-мостя чувствительности фотоприемников уровень ннжекции генерируемых светом носителей мал; - эффективное время жизни носителей заряда в базе совпадает с временем жизни дырок Тр; - отражение света от поверхности кристалла пренебрежимо мало. При экспоненциальном законе поглощения излучения вида (1.9), полагая Р=1 и пренебрегая диффузионным выравниванием, для концентрации генерированных дырок получаем р = роехр (-х/хо), где ро=5-Ш"ЯРфогр/?<о. (1.25) Здесь р, Ро, см-; Хо, см; X, мкм; Рфо, мВт/см; Тр, с. p,yc/i.ei.  !ff х,мнм Рис. 1.14. Распределение концентрации избыточных дырок в базе кремниевого фотодиода при засветке от различных излучателей Примеры распределения концентрации дырок в базе кремниевого фотодиода для типичных «оптронных» излучателей (рис. 1.14) показывают, что при уменьшении длины волны граничная концентрация возрастает и все распределение «прижимается» к р-«-переходу. Характерно при этом, что полное количество избыточных носителей заряда в базе, равное (при достаточно толстой базе) f = Л р (*) = ЛРох. = 5.10 МХРфоХр о fздесь Л-площадь р-п-нерехода, см), слабо зависит от Я, и для тех незначительных различий но X, которые имеют место у оптронных излучателей, практически неизменно. Рассмотрим р+-и-п+-структуру (рис. 1.11,а). Будем считать, что Xoip (ip= Kdt - диффузионная длина дырок в «-области), ибо лишь в этом случае коэффициент собирания Q ие слишком мал. Экспоненциальный закон распределения избыточных дырок в базе днода с показателем экспоненты x/KaixILp показывает, что ситуация подобна той, которая возникает при нротеканнн через диод короткого неустановившегося импульса прямого тока [12]. Используя формулы из [12] и учитывая конечность базовой области фотодиода, получаем Q= (1-Хо/2Ьр) [1-ехр (-«/ip)]. (1.26) Первый член в этом соотношении учитывает рекомбииациоиные потери в базе, второй--«бесполезную» генерацию носителей в п+- области. Для р-г-«-структуры (рис. 1.11,6), когда носители иод действием встроенного ноля пролетают область базы за время, много меньшее Тр, рекомбинациоиными потерями в базе можно пренебречь и в выражении для Q остается лишь второй член; при W> >(2 ... 3)хо практически Qs-l. Выражение (1.26) дает и спектральную зависимость Q при известном виде функции Хо(Л). В заключение этого расчета заметим, что предположение о нре-иебрежимости шириной области объемного заряда /оз (по сравнению с Хо, Lp и W) несправедливо (рис. 1.15). В p-i-га-структурах уже при (/обр1 ... 2 В /оз>хо, поэтому величина Q практически ие зависит от обратного напряжения; для диодов с р-га-переход ом, напротив, характерно заметное снижение Q (и соответственно S) при уменьшении напряжения. 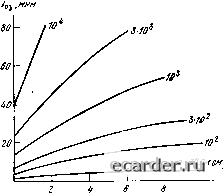 Рис. 1.15. Зависимость ширины области объемного заряда от обратного напряжения Выше отмечалось, что фотодиод в оптроне может использоваться и в фотовентильном режиме. ЭДС холостого хода легко находится но формуле Больцмана для высоты потенциального барьера в области р-га-нерехода: Р» + Рп, (1.27) где Рпо - равновесная концентрация дырок в базе неосвещеииого фотодиода. Учитывая (1.25) и имея в виду, что р„о=пг/п„о, по-лучаем In 5.10» ГРфо- (1.28) Для кремния при комнатной температуре (йГ/о=0,025 В, га,- = = 2-102<1 см-") при типичных Я=к0,95 мкм, га„о=5-10 см-з (р= = 10 Ом-см), Тр=10- с и Рфо=30 мВт/см2 получаем Uxx = 460 мВ. Полученное из зарядовых соотношений выражение при учете того, что /ф~ро н /т~Рпо, сводится к общеизвестной форме (см., например, [11, 15]): = - 1п --,- q /т (1.29) Из (1.28) следует, что при каждом двукратном увеличении мощности облучения Uxx возрастает на ~18 мВ и оно тем меньше, чем выше удельное сопротивление базовой области. Формула (1.27) и вытекающие из нее следствия справедливы в том диапазоне изменения облученности (я соответственно значений ро и /кз), когда,   1 г 3 7фп/Лл Рис. 1.16. Вид функции Кг(0/Ошзл) (в) и /<;жн(Пжм) (S) с одной стороны, ро»Рпо (т. е. /кз>/т), а с другой - потенциальный барьер на р-п-переходе далек от полного «исчезновения», т. е. (!po-Uj,j,)/kT>l (здесь (ро -контактная разность потенциалов на р-п-переходе). Естественно, что предельная величина С/ц (при большой облученности) может быть близка к фо, определяемой как Для типичного р-i-п-диода (ppo=10i см-, п„,= 1вз см-) получаем t/iimai = 620 мВ, для фотодиода с р-и-переходом эта величина может достигать 700 . .. 750 мВ. Зиаченне тока короткого замыкания определяется пр»сто как /„з=Яф„5(0)Л, 01.31) где S(0)-чувствительность фотодиода при нулевом напряжении смещения. Возвращаясь к формуле (1.13), отметим, что величина коэффициента формы а в (1.13) зависит от внутреннего последовательиего сопротивления фотодиодной структуры и, как правило, близка -к 0,7 ... 0,8. Расчет светопередачи от излучателя к фотоприемнику крайне сложен, так как она зависит от очень многих факторов: отношения Офи/0„зп, расстояния между излучателем и фотоприемником d, не-соосностн н непараллельности кристаллов, диаграммы направленности излучателя и т. п. В общем случае аналитические формулы нолучить не удалось. Для конструкции на рис. 1,3,а с ламбертов-ским излучателем численный расчет и эксперимент [16] позволили получить графическое выражение для /(г(Офп ?жал), анализ кото- рого показывает (рнс. 1.16,а), что оптимальным следует признать отношение /)фп/£жзл~2 ... 2,5. Выигрыш в светопередаче прн погружении кристаллов излучателя и фотоприемннка в иммерсионную среду с показателем преломления Пям по сравнению со случаем воздушного промежутка между этими кристаллами дается формулой 1 - cos arc sin (Пим/«изл) 1 - cos arc sin (1 /Пизл) Аппроксимация теоретической кривой (рис. 1.16,6) в практически наиболее интересном диапазоне 1<п„„<2 дает Кип„м. Подставляя в (1.18) выражение (1.24) и полагая, что р-1-п-фотодиод (Q->-1) имеет достаточно большую площадь (Кг->-1), получаем для теоретически предельного значения коэффициента передачи тока оптрона простое и компактное выражение max Кг = ц,х1п\и, (1.32) где, еще раз подчеркнем, rjet - внешний квантовый выход кристалла светодиода, учитывающий мощность излучения в воздух лишь в одну сторону от излучающей плоскости. От.метим, что соотношение (1.32) вытекает и просто из определення параметра rieit. В заключение этого параграфа кратко рассмотрим другие определяющие параметры оптрона. Динамические характеристики (подробно рассматриваемые в § 3.5) определяются значениями временных параметров и барьерных емкостей излучателя и фотоприемника. В обеих активных структурах могут быть выделены постоянная времени днффузионно-дрей-фового распространения носителей /дд н эффективное время жизни Таф. Рассматриваемые структуры по геометрической модели относятся к плоскостным диодам либо с тонкой, либо с полубесконечной базой, поэтому для определения соответствующих постоянных времени пригодны следующие формулы [12]: для излучателя - барьерная емкость Ср „ = Л \/ee,qN/2 (?.-[/„,), - эффективное время жизни носителей заряда эф = (1 /-Сбезызл + 1 /-сизл) -, - диффузионно-дейфовая иостояннаи времени /дд={у720„ для двойной гетероструктуры, t = wy2D„ (либо Тп,ф) для одинарной гетероструктуры для фотодиода - барьерная емкость Cp-n==A{t&o/W) для р-i-п-структуры, С р-п = Л /ее„9Лд/2 (f/обр -Ь ¥„) для / - п-перехвда, - эффективное время жизни носителей заряда тоф, - днффузиояно-дрейфовая постоянная времени <дд= W/2Dp[9(Uo6p+9o)/7] для р-/-и-структуры, tKx=/2Dp (либо Тр,ф) для р-п-перехода. 0 1 2 3 4 5 [6] 7 8 9 10 11 12 13 14 15 16 17 18 19 20 21 22 23 24 25 26 27 28 29 30 31 32 33 34 35 36 37 38 39 40 41 42 43 44 45 |